액침 노광
"오늘의AI위키"의 AI를 통해 더욱 풍부하고 폭넓은 지식 경험을 누리세요.
1. 개요
액침 노광은 광학 리소그래피 기술의 일종으로, 렌즈와 웨이퍼 사이에 굴절률이 높은 액체(주로 초순수)를 채워 빛의 파장을 줄임으로써 해상도를 높이는 기술이다. 1980년대에 아이디어가 제안되었으며, 2000년대 초반 IBM에서 상용화 계획을 발표했다. 액침 노광은 해상도 향상과 더불어 초점 심도를 개선하지만, 액체의 온도 변화, 순도 유지, 웨이퍼 손상 등의 기술적 문제와 편광 효과, 처리량, 다중 패터닝 등의 과제를 가진다. 반도체 제조 외에도 광학 현미경의 고배율 관찰에도 활용된다.
더 읽어볼만한 페이지
- 리소그래피 - 포토리소그래피
포토리소그래피는 빛을 이용하여 기판 위에 패턴을 형성하는 기술로, 반도체 제조 공정에서 회로 패턴을 형성하는 핵심 기술이며, 석판화에서 유래되어 극자외선 기술까지 발전했다. - 리소그래피 - 포토마스크
포토마스크는 반도체, 디스플레이, 인쇄 회로 기판 제조 시 웨이퍼에 회로 패턴을 전사하는 마스크로, 기술 발전을 거듭하며 융용 실리카 기판과 금속 흡수막을 사용하고 위상 천이 마스크, EUV 마스크 등의 고급 기술이 개발되어 반도체 미세화에 기여하고 있지만, 높은 제작 비용과 기술적 어려움은 해결해야 할 과제이다. - 나노기술 - 나노 기술
나노 기술은 분자 수준에서 물질을 다루는 과학 및 공학 기술로, 다양한 접근 방식을 통해 여러 분야에 응용되며 독특한 특성을 나타내지만, 독성, 환경 문제 등 윤리적 고려 사항이 존재한다. - 나노기술 - 그레이 구
그레이 구는 분자 나노기술의 자기 복제 기계가 통제 불능 상태로 증식하여 지구를 파괴할 수 있다는 가설이며, 기술 윤리, 특히 나노기술의 잠재적 위험성을 논의하는 데 중요한 개념으로 활용된다. - 광학 - 광자
광자는 전자기파의 기본 입자이자 빛의 입자적 성질을 나타내는 양자이며, 전하를 띠지 않고 에너지와 운동량을 가지며 다양한 기술 분야에 응용된다. - 광학 - 굴절
굴절은 빛이 한 매질에서 다른 매질로 진행할 때 속도 변화로 인해 진행 방향이 꺾이는 현상이며, 렌즈, 프리즘, 광섬유 등 다양한 분야에 응용된다.
| 액침 노광 | |
|---|---|
| 개요 | |
 | |
| 기술 종류 | 포토리소그래피 |
| 특징 | 액체 매질 사용 |
| 액체 매질 종류 | 물, 기타 액체 |
| 용도 | 마이크로칩 제조 |
| 작동 원리 | |
| 분해능 향상 | 액체 매질의 굴절률 이용 |
| 굴절률 | 공기보다 높은 굴절률 사용 |
| 주요 효과 | 더 미세한 패턴 형성 가능 심자외선(DUV) 노광 시스템 성능 향상 |
| 기술적 이점 | |
| 해상도 증가 | 기존 건식 노광 대비 향상 |
| 심도 확장 | 더 넓은 범위에서 초점 유지 |
| 기술적 과제 | |
| 액체 관련 문제 | 액체 오염 기포 형성 재료 호환성 |
| 해결 과제 | 액체 정제 기술 개발 새로운 재료 연구 |
| 활용 분야 | |
| 주요 응용 | 고성능 마이크로칩 생산 |
| 적용 기술 | 22nm 이하 공정 |
| 관련 기업 | 인텔 TSMC 삼성전자 |
| 관련 정보 | |
| 관련 기술 | 포토리소그래피 |
| 관련 용어 | 심자외선(DUV) 노광 극자외선(EUV) 노광 |
2. 역사적 배경
광학 리소그래피에서 특징을 식별하는 능력은 이미징 장비의 개구수와 직접적으로 관련이 있으며, 개구수는 빛이 통과하는 매질의 굴절률에 최대 굴절각의 사인을 곱한 값이다. 최고 해상도 "건식" 포토 리소그래피 스캐너의 렌즈는 웨이퍼 표면에 거의 평행한 경계를 가진 원뿔 모양으로 빛을 모은다. 더 이상의 굴절로는 해상도를 높일 수 없으므로, 렌즈와 웨이퍼 사이에 더 높은 굴절률을 가진 액침 매질을 삽입하여 추가 해상도를 얻는다. 흐릿함은 매질의 굴절률에 해당하는 인수로 감소한다. 예를 들어, 193 nm 파장의 자외선을 사용하는 물 액침의 경우 굴절률은 1.44이다.[3] 액침 리소그래피로 인한 해상도 향상은 사용된 재료에 따라 약 30–40%이다. 그러나 동일한 해상도에서 해당 "건식" 도구에 비해 초점 심도, 즉 웨이퍼 지형 평탄도의 허용 오차가 개선된다.[4]
광학 리소그래피에서 식별 가능한 특징은 이미징 장비의 개구수(NA)와 관련이 있으며, 개구수는 빛이 통과하는 매질의 굴절률에 최대 굴절각의 사인을 곱한 값이다. 렌즈와 웨이퍼 사이에 더 높은 굴절률을 가진 액침 매질을 삽입하여 해상도를 높일 수 있다. 예를 들어, 193nm 파장의 자외선을 사용하는 물 액침의 경우 굴절률은 1.44이다. 액침 리소그래피로 인한 해상도 향상은 사용된 재료에 따라 약 30–40%이다.
액침 리소그래피에 대한 아이디어는 1984년 Takanashi et al.에 의해 특허를 받았다.[5] 또한 대만 엔지니어 린 번 J.에 의해 제안되었으며 1980년대에 실현되었다.[6] 2004년, IBM의 실리콘 기술 이사인 가밤 샤히디는 IBM이 물을 통해 필터링된 빛을 기반으로 하는 리소그래피를 상용화할 계획이라고 발표했다.[7] 1990년대 말에는 포스트 ArF 기술로 EUV 노광이 유력하게 여겨졌으며, F2 레이저 개발도 병행되었다. 2007년에는 초순수(굴절률 1.33)를 사용한 액침 기술의 실용화가 진행되었고, 더 높은 굴절률의 액체 사용도 검토되었다.
3. 원리
반도체 회로 제조에서는 스텝퍼의 투영 렌즈를 사용하여 웨이퍼에 도포된 포토레지스트의 감광에 의한 회로 패턴 전사가 이루어진다.
투영 렌즈와 웨이퍼 표면의 레지스트 사이에 굴절률이 높은 액체(일반적으로 초순수)를 삽입하여 빛의 파장을 대기 중보다 짧게 함으로써 해상도를 높이는 기술을 액침 기술이라고 한다. 일반적으로 사용되는 것은 초순수이며, 파장 193 nm의 ArF레이저 광에서 초순수의 굴절률은 1.44이므로, 초순수 내에서 빛의 파장은 134nm로 짧아진다.
일반적으로 반도체는 구성 회로가 미세할수록 고속 동작, 저전력성, 저발열성 등에 유리하다고 여겨진다.[18] 1990년대 말에는 포스트 ArF 기술로 EUV 노광이 유력하게 여겨졌으며, F2 레이저 개발도 병행하여 진행되었다.[19][20]
웨이퍼와 투영 렌즈 사이를 액체로 채워 더 미세한 노광을 하는 기술은 광학 현미경의 고배율 관찰에 예전부터 사용되었지만, 반도체 제조에 적용된 것은 기술적인 문제가 해결되었기 때문이다.
2007년 현재 액침 기술에는 초순수 (굴절률 1.33)를 사용한 실용화가 진행되고 있으며, 더욱 고굴절률의 액체 사용도 검토되고 있다.
반도체 노광을 액침으로 할 때 다음과 같은 문제들이 있었다.
이러한 문제의 해결에 대해서는 어느 정도 해결의 실마리가 보이며, 실용화되었다.[21][22]
4. 기술적 문제 및 해결
포토레지스트-물 접착력 손실(에어 갭 또는 기포) 및 잔류하는 물(워터마크)과 같은 결함 문제로 인해 포토레지스트 위에 직접 탑코트 층을 사용하는 방안이 고려되었다.[8] 이 탑코트는 액체 매질과 포토레지스트 사이의 화학적 확산에 대한 장벽 역할을 한다.[8] 또한, 워터마크 감소를 위해 액체와 탑코트 사이의 계면을 최적화하며, 동시에 탑코트 사용으로 인한 결함은 피해야 한다.
2005년 기준으로, 탑코트는 특히 초고 NA(NA>1)의 경우 반사 방지 코팅으로 사용하기 위해 조정되었다.[9]
2008년까지 액침 리소그래피로 인쇄된 웨이퍼의 결함 수는 제로 수준의 성능에 도달했다.[10]
5. 편광 영향
2000년 기준으로, 편광 효과는 포토레지스트 내 간섭의 높은 각도로 인해 특징이 40nm에 접근하면서 중요하게 여겨졌다.[11] 이상적인 라인-스페이스 이미징을 위해 조명원은 일반적으로 극 조명과 일치하도록 방위각 편광이 필요하다.[12]
6. 처리량(Throughput)
1996년에는 더 높은 스테이지 속도를 통해 처리량이 향상되었으며,[13][14] 2013년에는 더 높은 출력의 ArF 레이저 펄스 소스에 의해 가능해졌다.[15] 처리량은 스테이지 속도에 정비례하며, 스테이지 속도는 선량, 직사각형 슬릿 폭, 슬릿 강도에 의해 결정된다. 슬릿 강도는 펄스 출력과 직접 관련이 있다. 슬릿 폭은 선량을 만들기 위한 펄스 수를 레이저 펄스 주파수로 나눈 값에 최대 스캔 속도를 곱하여 결정된다.[13] 따라서 주어진 선량에서의 처리량은 최대 스테이지 속도를 높이고 펄스 출력을 증가시킴으로써 향상된다.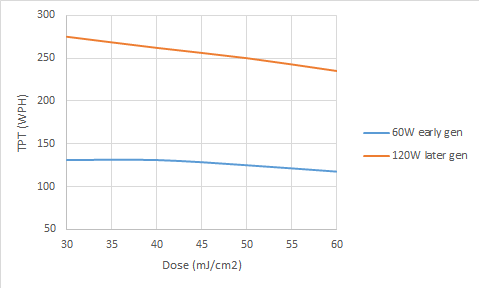
ASML의 twinscan-nxt1980di는 현재(2022년 11월 기준) 대량 생산을 목표로 하여 가장 높은 처리량 (275 WPH)을 자랑한다.[16]
7. 다중 패터닝(Multiple Patterning)
193nm 파장에서 작동하는 1.35 NA 액침 도구의 해상도 한계는 36nm이다.[17] 이 한계를 넘어 20nm 이하 노드로 진입하려면 멀티플 패터닝이 필요하다.[17] 20nm 파운드리 및 메모리 노드 이후부터는, 가장 밀도가 높은 레이어를 위해 액침 리소그래피를 사용하여 더블 패터닝과 트리플 패터닝이 이미 사용되고 있다.

8. 반도체 제조 외 응용
8. 1. 현미경

광학 현미경에서는 40~100배 정도의 고배율·고분해능 대물렌즈에 액침 기술이 사용된다.[23] 고배율·고개구수 렌즈는 관찰물(커버글라스)에 접하는 렌즈가 매우 작고, 관찰물에 가까이 접근하여 관찰이 이루어진다. 이 때문에 콘덴서에서 입사하는 빛 중, 입사각이 얕은 것은 대물렌즈의 선단, 그리고 프레파라트와 공기면의 경계에서 전반사를 일으켜 대물렌즈 이후의 광학계로 들어갈 수 없다. 이 현상 때문에 대물렌즈의 개구수의 이론적 한계가 1.0이 된다.(실제로는 다른 요인으로 인해 0.95 정도가 한계)
커버글라스와 대물렌즈 사이를 액체로 채움으로써 개구수를 향상시키는 것이 가능하다. 액체에는 일반적으로 광학 오일(이머전 오일: 굴절률 1.51)을 사용한다. 이 관찰에 대응하는 렌즈를 액침 렌즈 또는 '''유침 렌즈'''라고 부른다. 대물렌즈에 따라 다르지만, 액침을 수행함으로써 개구수 1.2~1.6 정도를 실현할 수 있으며, 분해능은 1.2~1.6배로 향상된다. 이로 인해 200nm 정도의 구조를 관찰하는 것이 가능해진다. 세균학 등 광학 현미경으로 특히 미세한 것을 관찰할 경우 일반적으로 사용된다. 콘덴서와 슬라이드글라스 사이에도 액침을 수행할 필요가 있다.
현미경 액침에는 물, 글리세린, 아니솔 등이 사용될 수 있다. 물은 살아있는 플랑크톤 등, 물을 봉입에 사용한 프레파라트 관찰에서 고분해능이 필요한 경우, 유침을 수행하면 구면 수차가 발생할 수 있으며, 이를 피하기 위해 사용된다. 수침(:en:Water immersion objective)이라고 불릴 때도 있다. 굴절률 1.33, 전용 수침 렌즈를 사용한다. 글리세린은 형광 관찰에서 자기 형광을 극도로 꺼리는 경우 사용되며, 굴절률은 1.47이고 전용 글리세린 침 렌즈를 사용한다. 아니솔은 이머전 오일과 굴절률이 거의 동일하며(굴절률 1.51), 대용하면 휘발성이 있어 세척이 용이하다[24]. 단, 유기 용제이므로, 경우에 따라 대물렌즈의 렌즈 고정제를 침범할 수 있으므로 주의해야 한다. 범용 유침 렌즈가 사용 가능하다.
주사 전자 현미경에서, 비슷한 역할을 하는 렌즈를 유침 렌즈(계침 렌즈)라고 부르기도 한다.
참조
[1]
논문
Benefits and limitations of immersion lithography
http://nanolithograp[...]
2004-01-01
[2]
웹사이트
DailyTech - IDF09 Intel Demonstrates First 22nm Chips Discusses Die Shrink Roadmap
https://web.archive.[...]
2009-12-07
[3]
서적
Optical Microlithography XVI
SPIE
2003-06-26
[4]
문서
2002
[5]
특허
U. S. Patent No. 4,480,910
1984
[6]
간행물
The future of subhalf-micrometer optical lithography
1987
[7]
웹사이트
A Whole New World of Chips
https://web.archive.[...]
[8]
서적
Advanced Processes for 193-nm Immersion Lithography
SPIE
2009
[9]
간행물
2005
[10]
간행물
https://www.research[...]
2008
[11]
간행물
2000
[12]
간행물
2004
[13]
웹사이트
M. A. van den Brink et al., Proc. SPIE 2726, 734 (1996).
https://web.archive.[...]
2018-07-16
[14]
간행물
2012
[15]
웹사이트
120-W ArFi Laser Makes Higher-Dose Lithography Possible
https://www.photonic[...]
2013
[16]
웹사이트
The ASML NXT:1980Di lithography system
https://www.asml.com[...]
nd
[17]
웹사이트
193i Lithography Takes Center Stage...Again
https://semiengineer[...]
2023
[18]
문서
これは一般論である。極端に微細化すると、回路からのリーク電流などが問題となるとされる。
[19]
웹사이트
福田昭のデバイス通信(85):「SEMICON West 2016」、半導体露光技術の進化を振り返る(完結編その2) (2/2) - EE Times Japan
https://eetimes.itme[...]
2016-08-30
[20]
웹사이트
話題の技術 : 液浸露光技術
http://www.shmj.or.j[...]
日本半導体歴史館
[21]
뉴스
日経ビジネス
http://it.nikkei.co.[...]
[22]
웹사이트
量産化に向けた生産技術 : 液浸リソグラフィの開発
http://jpn.nec.com/t[...]
NEC
[23]
웹사이트
オリンパス 生物顕微鏡・バイオイメージング:全反射蛍光顕微鏡システム TIRFM:特長(3)
http://www.olympus.c[...]
オリンパス
[24]
문서
イマージョンオイルはキシレンを用いてふき取る必要があり、清掃せずに放置すると固着してレンズを傷める。また、こぼれると揮発性が低いため乾燥せず、除去が厄介である。
본 사이트는 AI가 위키백과와 뉴스 기사,정부 간행물,학술 논문등을 바탕으로 정보를 가공하여 제공하는 백과사전형 서비스입니다.
모든 문서는 AI에 의해 자동 생성되며, CC BY-SA 4.0 라이선스에 따라 이용할 수 있습니다.
하지만, 위키백과나 뉴스 기사 자체에 오류, 부정확한 정보, 또는 가짜 뉴스가 포함될 수 있으며, AI는 이러한 내용을 완벽하게 걸러내지 못할 수 있습니다.
따라서 제공되는 정보에 일부 오류나 편향이 있을 수 있으므로, 중요한 정보는 반드시 다른 출처를 통해 교차 검증하시기 바랍니다.
문의하기 : help@durumis.com