전자빔 리소그래피
"오늘의AI위키"의 AI를 통해 더욱 풍부하고 폭넓은 지식 경험을 누리세요.
1. 개요
전자빔 리소그래피는 전자빔을 사용하여 기판에 미세한 패턴을 형성하는 기술이다. 전자빔 노광 장치는 빔 형태와 빔 편향 전략에 따라 스팟 빔, 가변 성형 빔, 캐릭터 프로젝션 방식 빔으로 분류되며, 전자총, 블랭킹 기구, 전자 렌즈, 편향기, X-Y-Z 스테이지 등 다양한 구성 요소로 이루어져 있다. 낮은 처리량, 샷 노이즈, 결함 발생, 근접 효과, 전하 축적 등의 과제를 가지고 있으며, 저에너지 전자빔, 다중 전자빔, 신소재 레지스트 개발을 통해 기술 발전을 모색하고 있다. 주요 제조사로는 뉴플레어테크놀로지, 일본전자, 히타치하이테크놀로지즈 등이 있다.
더 읽어볼만한 페이지
- 전자빔 - 저에너지 전자 회절
저에너지 전자 회절(LEED)은 저에너지 전자빔을 시료 표면에 조사하여 발생하는 회절 패턴을 분석하여 표면의 원자 구조를 연구하는 표면 과학 기법으로, 표면에 민감하여 표면층의 원자 배열, 재구성, 흡착물의 구조 등을 밝히는 데 사용된다. - 전자빔 - 투과전자현미경
투과전자현미경(TEM)은 전자빔 투과율 차이를 영상화하는 현미경으로, 짧은 파장 전자를 이용하여 고해상도 이미징을 통해 생물학, 재료과학 등에서 미세구조 분석에 활용되며, 다양한 형태로 발전하고 있다. - 리소그래피 - 포토리소그래피
포토리소그래피는 빛을 이용하여 기판 위에 패턴을 형성하는 기술로, 반도체 제조 공정에서 회로 패턴을 형성하는 핵심 기술이며, 석판화에서 유래되어 극자외선 기술까지 발전했다. - 리소그래피 - 포토마스크
포토마스크는 반도체, 디스플레이, 인쇄 회로 기판 제조 시 웨이퍼에 회로 패턴을 전사하는 마스크로, 기술 발전을 거듭하며 융용 실리카 기판과 금속 흡수막을 사용하고 위상 천이 마스크, EUV 마스크 등의 고급 기술이 개발되어 반도체 미세화에 기여하고 있지만, 높은 제작 비용과 기술적 어려움은 해결해야 할 과제이다.
| 전자빔 리소그래피 | |
|---|---|
| 전자빔 리소그래피 | |
 | |
| 기술 분야 | 미세 가공 |
| 작동 원리 | 전자빔을 사용하여 레지스트에 패턴을 기록 전자빔은 레지스트에 화학적 변화를 일으켜 노출된 영역을 용해하거나 불용성으로 만듦 용매 또는 에칭을 사용하여 패턴이 있는 레지스트를 제거한 후 하부 재료를 처리하여 최종 장치 또는 구조를 형성 |
| 해상도 | 10 nm 이하 |
| 전자빔 리소그래피 시스템 구성 요소 | |
| 전자총 | 전자 빔을 생성하는 데 사용되는 부품 일반적으로 열전자 방출 또는 장 효과 방출을 사용 |
| 전자 광학 장치 | 전자 빔을 형성하고 조작하는 데 사용되는 일련의 렌즈와 조리개 전자 빔을 특정 크기와 모양으로 만들고, 시료 표면에 정확하게 초점을 맞춤 |
| 편향 시스템 | 전자 빔을 시료 표면 전체에 이동시키는 데 사용되는 시스템 전기 또는 자기 편향기를 사용하여 빔을 제어 |
| 스테이지 | 시료를 잡고 이동시키는 데 사용되는 기계 장치 시료를 전자 빔 아래에 정확하게 위치시키기 위해 사용 |
| 전자빔 리소그래피의 주요 단계 | |
| 레지스트 도포 | 레지스트라 불리는 감광성 재료를 기판에 코팅하는 단계 레지스트는 전자 빔에 노출되면 화학적 변화를 일으킴 |
| 전자빔 노광 | 전자빔을 사용하여 레지스트에 원하는 패턴을 기록 전자빔은 기판 표면에 직접 쓰기 위해 스캔 방식으로 이동 |
| 현상 | 노광된 레지스트를 용매에 담가 노광된 부분을 제거하는 단계 패턴을 남기는 과정 |
| 에칭 | 패턴이 있는 레지스트를 사용하여 기판의 하부 재료를 에칭하는 단계 화학적 또는 물리적 에칭 프로세스를 사용하여 재료를 제거 |
| 레지스트 제거 | 에칭 후 레지스트를 제거하는 단계 하부 재료에 형성된 패턴을 남김 |
| 전자빔 리소그래피의 장점 | |
| 고해상도 | 매우 작은 특징을 만들 수 있음 |
| 유연성 | 복잡한 패턴을 만들 수 있으며 다양한 재료에 적용 가능 |
| 직접 기록 | 마스크가 필요하지 않으므로 프로토타입 제작에 유용 |
| 전자빔 리소그래피의 단점 | |
| 느린 처리 속도 | 대량 생산에 적합하지 않음 |
| 높은 비용 | 장비 비용이 높고 운영 및 유지 관리에 많은 비용이 소요 |
| 근접 효과 | 전자 산란으로 인해 인접한 특징에 왜곡이 발생할 수 있음 |
| 응용 분야 | |
| 반도체 제조 | 고성능 트랜지스터, 메모리 및 기타 전자 장치 제작 나노 기술 연구 및 개발에도 널리 사용 |
| 광학 소자 | 광결정, 회절격자, 메타 물질 등의 광학 소자 제작 데이터 저장, 디스플레이 기술 및 센서 개발 |
| 바이오 기술 | 미세 유체 장치 및 세포 분석 플랫폼 제작 생체 재료 연구에도 응용 |
| 재료 과학 | 나노 와이어, 나노 입자 및 기타 나노 재료 제작 재료 특성 연구에 사용 |
| 기술 개발 | |
| 다중 전자빔 리소그래피 | 처리 속도를 높이기 위해 여러 개의 전자빔을 동시에 사용하는 기술 |
| 화학 증폭 레지스트 | 노광 속도와 감도를 높이는 데 사용되는 레지스트 |
| 근접 효과 보정 | 전자 산란의 영향을 줄이기 위한 방법 |
| 전자빔 리소그래피 용어 | |
| 백스캐터링 | 전자빔이 재료와 상호 작용할 때 발생하는 전자 산란 현상 |
| 근접 효과 | 전자 산란으로 인해 인접한 특징의 이미지가 왜곡되는 현상 |
| 레지스트 | 전자빔에 반응하여 화학적 변화를 일으키는 재료 |
| 분해능 | 전자빔 리소그래피로 만들 수 있는 가장 작은 특징 크기 |
| 패턴 전송 | 레지스트 패턴을 하부 재료로 옮기는 과정 |
2. 전자빔 노광 장치의 종류
상용 분야에 사용되는 전자빔 노광 시스템은 매우 고가(100만 달러 이상)의 전용 전자빔 노광 장비이다. 연구 분야에서는 상대적으로 저렴한 부속품(10만 달러 미만)을 사용하여 전자 현미경을 전자빔 노광 시스템으로 개조하는 것이 일반적이다. 이렇게 개조된 시스템은 적어도 1990년 이후로 약 20nm의 선폭을 생성해 왔으며, 현재의 전용 시스템은 10nm 이하의 선폭을 생성한다.
전자빔 노광 시스템은 빔 형태와 빔 편향 전략에 따라 분류할 수 있다. 구형 시스템은 가우스 형태의 빔을 사용하여 래스터 방식으로 스캔했다. 최신 시스템은 노광 영역의 다양한 위치로 편향될 수 있는 형태의 빔을 사용하는데, 이는 '''벡터 스캔'''으로도 알려져 있다.
전자총(에미터 또는 캐소드)에서 방출되는 전자빔의 단면 형상이 원형이며, 편향기(디플렉터) 및 X-Y 스테이지의 이동과 동기시키면서 연속 조사하여 패턴을 그리는 것을 특징으로 한다. 전자빔의 지름은 변경할 수 있지만, 직사각형 빔에 비해 1샷당 빔 조사 면적이 작기 때문에 처리량은 나쁘다. 그러나 수십 nm ~ 수 nm까지의 미세한 패턴 작성이 가능하기 때문에, 주로 차세대 설계 규칙에 의한 시제품 제작이나 MEMS 등의 연구 개발에 사용된다.
전자총(에미터)에서 방출되는 전자빔을 성형 어퍼처라고 하는 직사각형 구멍을 여러 단계 통과시켜 전자빔 형상을 직사각형으로 바꾸고, X-Y 스테이지의 이동과 동기시키면서 연속 조사하여 패턴을 그리는 것을 특징으로 한다. 스팟빔에 비해 미세한 패턴은 작성할 수 없지만, 1샷당 작성 면적이 가변적이기 때문에 처리량이 좋으며, 레티클의 양산 공정용이나 양산용 LSI를 위한 레티클 작성에 사용된다.
특정 형상의 개구를 여러 개 형성한 마스크를 어퍼처로 사용하여, 마스크 내에 각 곳에서 사용되는 동일 형상의 패턴을 저가속 전자빔으로 노광하는 샷 수를 줄이고 고속화하는 비가변 성형 빔 노광 방식이다. 가변 성형 빔과 조합함으로써 웨이퍼에 대한 노광 처리량을 높인다.
2. 1. 스팟 빔 (포인트 빔)
전자총(에미터 또는 캐소드)에서 방출되는 전자빔의 단면 형상이 원형이며, 편향기(디플렉터) 및 X-Y 스테이지의 이동과 동기시키면서 연속 조사하여 패턴을 그리는 것을 특징으로 한다. 전자빔의 지름은 변경할 수 있지만, 직사각형 빔에 비해 1샷당 빔 조사 면적이 작기 때문에 처리량은 나쁘다. 그러나 수십 nm ~ 수 nm까지의 미세한 패턴 작성이 가능하기 때문에, 주로 차세대 설계 규칙에 의한 시제품 제작이나 MEMS 등의 연구 개발에 사용된다.2. 2. 가변 성형 빔 (직사각형 빔)
전자총(에미터)에서 방출되는 전자빔을 성형 어퍼처라고 하는 직사각형 구멍을 여러 단계 통과시켜 전자빔 형상을 직사각형으로 바꾸고, X-Y 스테이지의 이동과 동기시키면서 연속 조사하여 패턴을 그리는 것을 특징으로 한다. 스팟빔에 비해 미세한 패턴은 작성할 수 없지만, 1샷당 작성 면적이 가변적이기 때문에 처리량이 좋으며, 레티클의 양산 공정용이나 양산용 LSI를 위한 레티클 작성에 사용된다.2. 3. 캐릭터 프로젝션 (CP) 방식 빔
특정 형상의 개구를 여러 개 형성한 마스크를 어퍼처로 사용하여, 마스크 내에 각 곳에서 사용되는 동일 형상의 패턴을 저가속 전자빔으로 노광하는 샷 수를 줄이고 고속화하는 비가변 성형 빔 노광 방식이다. 가변 성형 빔과 조합함으로써 웨이퍼에 대한 노광 처리량을 높인다.3. 전자빔 노광 장치의 구성 요소
전자빔 노광 장치는 주사전자현미경(SEM)과 거의 동일한 구조를 가지고 있으며, 차이점은 미세한 이동이 가능한 정밀 X-Y 스테이지, 고진공 제어 기구, 미세 측정 기능, 온도 제어 기구, 블랭킹 기구, 빔 직경 측정 기구, 높이 검출기 등이다. 일부 제조업체에서는 전자 현미경을 개조하여 이러한 기능을 추가하여 전자빔 노광 장치로 만드는 서비스를 제공한다.
; 전자빔 발생 장치(전자총)
: 스팟 빔은 열전자 전계 방출형(Thermal FEG (T-FEG))으로 ZrO/W(산화 지르코늄 텅스텐)이, 직사각형 빔은 LaB6(육붕화란탄) 단결정이 많이 사용된다.
; 블랭킹 기구
: X-Y 스테이지 이동 시나 편광기로 인한 전자빔 조사 위치 이동 시, 전자빔을 그대로 조사하면 이동 궤적에 따라 노광되어 불편하기 때문에, 또한 빔 발생원으로부터의 전자빔 조사를 멈추면 다시 출력할 때 전자빔이 안정될 때까지 시간이 걸린다. 따라서 전자빔 출력은 멈추지 않고 노광하지 않을 경우 블랭킹 기구를 작동시킨다. 블랭킹 기구에는 전자빔 편향기와 블랭킹 전용 아퍼처를 사용하는 경우가 많다.
; 고전압 발생부
: 10KV~100KV 정도의 고전압을 고정밀도로 안정적으로 공급한다.
; 전자렌즈
: 정전 편향, 전자기 편향에 의해 전자빔을 축소하거나 초점을 맞춘다.
; 편향기(디플렉터)
: 전자빔을 일정 범위 내에서 임의의 위치에 조사하기 위해 정전 편향기 또는 전자기 편향기를 사용한다. X-Y-Z 스테이지는 제어하기 어려운 수십 μm~nm 단위의 빔 위치 보정 등을 수행한다.
; 수차 보정
: 대물 아퍼처나 정전식 수차 보정 전극 등을 사용하여 여러 가지 수차를 보정한다.
; X-Y-Z 스테이지
: 패턴 노광에 맞춰 일정한 단계로 스테이지를 움직인다. 스테이지 이동량 제어에는 진공 챔버 외부에 설치된 모터와 레이저 간섭식 측정기 또는 진공 챔버 내부에 설치된 비자성·진공 모터와 리니어 스케일이 사용되며, 수십 μm~nm 단위의 이동 동작을 수행한다. 그 이하의 위치 제어는 편향기를 사용하는 경우가 많다. 비자성·진공 모터로는 리니어 초음파 모터가 사용된다.
; 반사 전자 검출기
: 노광 위치 검출이나 마크가 있는 웨이퍼의 위치 검출 등에도 사용된다.
; 이차 전자 검출기
: 이차 전자는 물체에 전자빔을 조사했을 때 물체의 매우 얕은 표면에서 방출되기 때문에 물체의 형상이나 표면 요철을 검출하는 데 적합하다. 전자빔 형상 측정이나 SEM 영상을 확인할 때 사용된다.
; 높이 검출기
: 웨이퍼나 마스크의 높이를 측정하여 전자빔 조사 시 초점 조정에 사용한다. 높이 측정에는 가시광선이나 적외선을 사용하는 경우가 많다.
; 전류 검출기
: 전자빔의 조사량은 마스크의 품질에 큰 영향을 미치기 때문에 일정 기간 동안 전자빔량이 정확한지 측정한다.
; 빔 직경 측정 기구
: 전자빔의 크기를 측정한다. 전자빔의 전류 검출 기능이 있는 나이프 에지라고 불리는 직사각형 개구부를 전자빔으로 스캔하여 전자빔의 단면 형상과 전류를 검출한다.
; 고진공 제어 기구
: 전자빔이 통과하는 부분은 고진공을 안정적으로 유지해야 하므로 회전펌프, 터보 분자 펌프, 이온 펌프 등을 병용하여 최대 10-8Pa 정도의 진공 상태를 유지한다. 또한 페닝 진공계, 이온화 진공계 등의 진공계로 항상 진공도를 확인한다. 전자총이 T-FEG인 경우 전자총 주변은 10-7Pa 정도의 진공도가 필요하다.
; 온도 제어 기구
: 수냉 등으로 작동 중에 열이 발생하는 전자렌즈, 스테이지, 유리 마스크, 웨이퍼, 증폭기의 정온도 제어를 실시한다.
3. 1. 전자빔 발생 장치 (전자총)
스팟 빔은 열전자 전계 방출형(Thermal FEG (T-FEG))으로 ZrO/W(산화 지르코늄 텅스텐)이, 직사각형 빔은 LaB6(육붕화란탄) 단결정이 많이 사용된다. 저해상도 시스템은 육붕화란탄으로 형성된 열전자원(음극)을 사용할 수 있다. 그러나 더 높은 해상도가 필요한 시스템은 가열된 W/ZrO2와 같은 전계 전자 방출원을 사용해야 한다. 열전계 방출원은 수 시간에 걸친 일반적인 노광 시간 동안 더 나은 안정성을 제공하기 때문에, 약간 더 큰 빔 크기에도 불구하고 저온 방출원보다 선호된다.3. 2. 블랭킹 기구
전자빔 노광 장치는 주사전자현미경(SEM)과 거의 동일한 구조를 가지지만, 미세 이동이 가능한 정밀 X-Y 스테이지, 고진공 제어 기구, 미세 측정 기능, 온도 제어 기구, 블랭킹 기구, 빔 직경 측정 기구, 높이 검출기 등이 추가된다. 일부 제조업체에서는 전자 현미경을 개조하여 이러한 기능을 추가하는 서비스를 제공한다.블랭킹 기구는 X-Y 스테이지 이동 시나 편광기로 인한 전자빔 조사 위치 이동 시, 또는 빔 발생원으로부터의 전자빔 조사를 멈추고 다시 출력할 때 전자빔이 안정될 때까지의 시간 동안 전자빔 조사를 막는 역할을 한다. 전자빔 출력은 멈추지 않고 노광하지 않을 경우 블랭킹 기구를 작동시키는데, 이때 전자빔 편향기와 블랭킹 전용 아퍼처를 사용하는 경우가 많다.
3. 3. 고전압 발생부
10KV~100KV 정도의 고전압을 고정밀도로 안정적으로 공급한다.3. 4. 전자 렌즈
정전 렌즈와 자기 렌즈 모두 전자빔 리소그래피에 사용될 수 있지만, 정전 렌즈는 수차가 커서 미세 초점에는 사용되지 않는다. 현재 무색수차 전자빔 렌즈를 만들 수 있는 기술은 없으므로, 미세한 초점을 위해서는 전자빔 에너지 분산을 매우 좁게 만들어야 한다. 전자빔 노광 장치는 주사전자현미경(SEM)과 구조가 유사하며, 미세 이동이 가능한 정밀 X-Y 스테이지, 고진공 제어 기구, 미세 측정 기능, 온도 제어 기구, 블랭킹 기구, 빔 직경 측정 기구, 높이 검출기 등이 추가된다.전자빔은 정전 편향 또는 전자기 편향에 의해 축소되거나 초점이 맞춰진다. 전자빔을 일정 범위 내에서 임의의 위치에 조사하기 위해 정전 편향기 또는 전자기 편향기가 사용되며, X-Y-Z 스테이지는 제어하기 어려운 수십 μm~nm 단위의 빔 위치 보정 등을 수행한다.
3. 5. 편향기 (디플렉터)
전자빔을 일정 범위 내에서 임의의 위치에 조사하기 위해 정전 편향기 또는 전자기 편향기를 사용한다. X-Y-Z 스테이지는 제어하기 어려운 수십 μm~nm 단위의 빔 위치 보정 등을 수행한다.3. 6. 수차 보정
대물 아퍼처나 정전식 수차 보정 전극 등을 사용하여 여러 가지 수차를 보정한다.3. 7. X-Y-Z 스테이지
전자빔 노광 장치는 주사전자현미경(SEM)과 거의 동일한 구조를 가지지만, 미세한 이동이 가능한 정밀 X-Y 스테이지, 고진공 제어 기구, 미세 측정 기능, 온도 제어 기구, 블랭킹 기구, 빔 직경 측정 기구, 높이 검출기 등이 추가된다. 일부 제조업체에서는 전자 현미경을 개조하여 이러한 기능을 추가하여 전자빔 노광 장치로 만드는 서비스를 제공한다.X-Y-Z 스테이지는 패턴 노광에 맞춰 일정한 단계로 움직인다. 스테이지 이동량 제어에는 진공 챔버 외부에 설치된 모터와 레이저 간섭식 측정기 또는 진공 챔버 내부에 설치된 비자성·진공 모터와 리니어 스케일이 사용되며, 수십 μm~nm 단위의 이동 동작을 수행한다. 그 이하의 위치 제어는 편향기를 사용하는 경우가 많다. 비자성·진공 모터로는 리니어 초음파 모터가 사용된다. 정확한 스테이지는 스티칭(기록 필드를 서로 정확하게 이어붙이기)과 패턴 오버레이(이전에 만들어진 패턴에 패턴을 정렬하기)에 매우 중요하다.
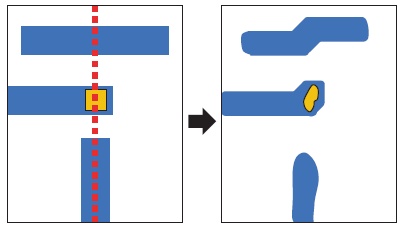
일반적으로 매우 작은 빔 편향의 경우 정전 편향 "렌즈"가 사용되며, 더 큰 빔 편향에는 전자기 스캐닝이 필요하다. 부정확성과 노출 격자의 유한한 단계 수 때문에, 기록 필드는 100마이크로미터 – 1mm 정도이다. 더 큰 패턴에는 스테이지 이동이 필요하다.
3. 8. 반사 전자 검출기
노광 위치 검출이나 마크가 있는 웨이퍼의 위치 검출 등에도 사용된다.3. 9. 이차 전자 검출기
이차 전자 검출기는 물체에 전자빔을 조사했을 때 물체의 매우 얕은 표면에서 방출되는 이차 전자를 이용하여 물체의 형상이나 표면 요철을 검출한다. 전자빔 형상 측정이나 주사전자현미경(SEM) 영상을 확인할 때 사용된다.3. 10. 높이 검출기
웨이퍼나 마스크의 높이를 측정하여 전자빔 조사 시 초점 조정에 사용한다. 높이 측정에는 가시광선이나 적외선을 사용하는 경우가 많다.분류:집적 회로 제조
분류:나노리소그래피
분류:전자 현미경
3. 11. 전류 검출기
전자빔의 조사량은 마스크의 품질에 큰 영향을 미치기 때문에 일정 기간 동안 전자빔량이 정확한지 측정하는 데 사용되는 검출기이다.3. 12. 빔 직경 측정 기구
전자빔의 크기를 측정한다. 전자빔의 전류 검출 기능이 있는 나이프 에지라고 불리는 직사각형 개구부를 전자빔으로 스캔하여 전자빔의 단면 형상과 전류를 검출한다.3. 13. 고진공 제어 기구
전자빔 노광 장치는 주사전자현미경(SEM)과 거의 동일한 구조를 가지며, 고진공 제어 기구를 포함한다. 전자빔이 통과하는 부분은 고진공을 안정적으로 유지해야 하므로 회전펌프, 터보 분자 펌프, 이온 펌프 등을 병용하여 최대 10-8Pa 정도의 진공 상태를 유지한다. 또한 페닝 진공계, 이온화 진공계 등의 진공계로 항상 진공도를 확인한다. 전자총이 열전자 전계 방출형(T-FEG)인 경우 전자총 주변은 10-7Pa 정도의 진공도가 필요하다.
3. 14. 온도 제어 기구
전자빔 노광 장치는 주사전자현미경(SEM)과 거의 동일한 구조를 가지며, 온도 제어 기구는 수냉 등으로 작동 중에 열이 발생하는 전자렌즈, 스테이지, 유리 마스크, 웨이퍼, 증폭기의 정온도 제어를 실시한다.
4. 전자빔 리소그래피의 과제
4. 1. 낮은 처리량
주어진 면적에 특정 선량을 노출하는 데 필요한 최소 시간은 다음 공식으로 나타낼 수 있다.[2]: ''D'' ''A'' = ''T'' ''I''
여기서 ''T''는 물체 노출 시간(노출 시간/단계 크기로 나눌 수 있음), ''I''는 빔 전류, ''D''는 선량, ''A''는 노출 면적이다.
예를 들어, 1 cm2의 노출 면적, 10−3 쿨롱/cm2의 선량, 10−9 암페어의 빔 전류를 가정하면 최소 쓰기 시간은 106초(약 12일)가 된다. 이 최소 쓰기 시간에는 스테이지의 왕복 이동 시간, 빔이 차단되는 시간(웨이퍼에서 편향되는 동안), 그리고 쓰기 중간에 발생할 수 있는 기타 빔 보정 및 조정 시간은 포함되지 않는다. 300 mm 실리콘 웨이퍼의 700 cm2 표면적을 처리하려면 최소 쓰기 시간은 7×108초, 즉 약 22년으로 늘어난다. 이는 현재 광학 리소그래피 장비보다 약 1천만 배 느린 것이다. 대면적에 고밀도 패턴을 쓰는 경우 처리량이 전자빔 리소그래피의 심각한 제약이라는 점이 명확하다.
전자빔 리소그래피는 처리량이 제한적이기 때문에 대량 생산에는 적합하지 않다. 전자빔 쓰기의 작은 필드는 광리소그래피(현재 표준)에 비해 패턴 생성 속도가 매우 느리다. 최종 패턴 영역을 형성하기 위해 더 많은 노출 필드를 스캔해야 하기 때문이다(전자빔의 경우 ≤mm2, 광학 마스크 투영 스캐너의 경우 ≥40 mm2). 스테이지는 필드 스캔 사이에 움직인다. 전자빔 필드는 매우 작기 때문에 예를 들어 26 mm × 33 mm 영역에 패턴을 형성하려면 래스터 또는 세르펜타인 스테이지 동작이 필요하지만, 광리소그래피 스캐너에서는 26 mm × 2 mm 슬릿 필드의 1차원 동작만 필요하다.
현재 광학 마스크리스 리소그래피 장비[3]는 동일한 해상도로 포토마스크 패터닝에 사용되는 전자빔 장비보다 훨씬 빠르다.
4. 2. 샷 노이즈
집적회로의 미세화가 진행됨에 따라, 일정 선량에서 입사하는 전자 수가 감소한다. 전자 수가 약 10,000개에 이르면 샷 노이즈 효과가 지배적이 되어 대규모 패턴 집단 내에서 상당한 자연적인 선량 변화를 초래한다.[4][5] 각 공정 노드마다 패턴 면적이 절반으로 줄어들면, 동일한 노이즈 수준을 유지하려면 최소 선량을 두 배로 늘려야 하며, 결과적으로 각 공정 노드마다 장비 처리량이 절반으로 줄어든다.| 패턴 지름 (nm) | 백만 분의 일 확률로 5% 선량 오차 발생 시 최소 선량 (μC/cm2) |
|---|---|
| 40 | 127 |
| 28 | 260 |
| 20 | 509 |
| 14 | 1039 |
| 10 | 2037 |
| 7 | 4158 |
모집단의 1 ppm은 평균 선량으로부터 약 5 표준 편차 떨어져 있다.
샷 노이즈는 마스크 제작에서도 중요한 고려 사항이다. 예를 들어 FEP-171과 같은 상용 마스크 전자빔 레지스트는 10 μC/cm2 미만의 선량을 사용하는데,[4][5] 이는 마스크 상에서 약 200 nm 정도의 목표 임계 치수(CD)에 대해서도 눈에 띄는 샷 노이즈를 유발한다.[6][7] 20 nm 미만의 패턴에서는 CD 변화가 15~20%에 달할 수 있다.[8][9]
4. 3. 결함 발생
전자빔 리소그래피는 높은 해상도를 가짐에도 불구하고, 과정에서 발생하는 결함은 간과되기 쉽다. 결함은 크게 데이터 관련 결함과 물리적 결함으로 분류할 수 있다.데이터 관련 결함은 전자빔이 제대로 편향되지 않아 발생하는 블랭킹(Blanking) 또는 편향 오류(deflection errors)와 가변형 빔 시스템에서 잘못된 형상이 시료에 투영될 때 발생하는 형상 오류(shaping errors)로 나뉜다. 이러한 오류는 전자 광학 제어 하드웨어 또는 테이프 아웃된 입력 데이터에서 발생할 수 있으며, 큰 데이터 파일일수록 데이터 관련 결함에 더 취약하다.
물리적 결함은 시료 대전(음전하 또는 양전하), 후방 산란 계산 오류, 선량 오류, 포깅(후방 산란 전자의 장거리 반사), 가스 방출, 오염, 빔 드리프트, 입자 등 다양하다. 전자빔 리소그래피의 쓰기 시간은 하루를 넘기기 쉬우므로, 임의로 발생하는 결함이 발생할 가능성이 높다. 큰 데이터 파일은 결함 발생 가능성을 더욱 높인다.
포토마스크 결함은 대부분 패턴 정의에 사용되는 전자빔 리소그래피 과정에서 발생한다.
4. 4. 근접 효과
전자빔 리소그래피로 생성된 가장 작은 패턴은 일반적으로 단일 패턴인데, 이는 인접 영역 노광에서 나온 전자가 현재 쓰이는 패턴의 노광으로 넘어가는 근접 효과 때문이다. 중첩된 패턴은 근접 효과를 악화시켜 패턴 이미지를 실제보다 크게 만들고 명암비를 감소시킨다.[26] 따라서 중첩된 패턴의 해상도는 제어하기 어렵다. 대부분의 레지스트에서 25 nm 이하의 선폭 및 간격을 얻기 어렵고, 20 nm 선폭 및 간격이 한계로 여겨진다.[26] 2차 전자 산란 범위는 때때로 100 nm를 초과하지만,[27] 30 nm 이하에서는 매우 중요해진다.[28]근접 효과는 레지스트 상단 표면을 떠난 후 수십 나노미터 거리에서 돌아오는 2차 전자에 의해서도 나타난다.[29]
전자 산란으로 인한 근접 효과는 역문제를 풀고, 산란 분포 점확산함수 ''PSF(x,y)''에 컨벌루션 했을 때 원하는 선량 ''D(x,y)''에 가능한 한 가까운 선량 분포를 만드는 노광 함수 ''E(x,y)''를 계산함으로써 해결할 수 있다. 그러나 적용된 선량의 오차(예: 샷 노이즈)는 근접 효과 보정의 실패를 초래할 수 있다.
4. 5. 전하 축적
전자는 대전된 입자이기 때문에, 접지 경로에 빠르게 접근할 수 없다면 기판에 음전하를 띠게 된다. 실리콘 웨이퍼에 입사하는 고에너지 빔의 경우, 거의 모든 전자는 웨이퍼 내에서 멈추고 접지 경로를 따라 이동할 수 있다. 그러나 포토마스크와 같은 석영 기판의 경우, 매립된 전자가 접지로 이동하는 데 훨씬 더 오랜 시간이 걸린다. 종종 기판이 얻는 음전하는 진공으로의 이차 전자 방출로 인한 표면의 양전하에 의해 상쇄되거나 심지어 초과될 수 있다. 저항체 위 또는 아래에 얇은 도전층이 있는 것은 일반적으로 고에너지(50 keV 이상) 전자빔에는 제한적인 효용이 있는데, 대부분의 전자가 이 층을 통과하여 기판으로 들어가기 때문이다. 전하 소산층은 일반적으로 10 keV 정도 또는 그 이하에서만 유용한데, 이는 저항체가 더 얇고 대부분의 전자가 저항체 내부 또는 도전층 근처에서 멈추기 때문이다. 그러나 이러한 층들은 높은 시트 저항으로 인해 효과적인 접지가 어려워 제한적인 효용성을 가진다.전하 축적에 기여할 수 있는 저에너지 이차 전자(저항체-기판 시스템에서 자유 전자 개체의 가장 큰 구성 요소)의 범위는 고정된 수치가 아니며 0에서 최대 50 nm까지 다양할 수 있다(새로운 지평 및 극자외선 노광 섹션 참조). 따라서 저항체-기판 전하 축적은 반복되지 않으며 일관되게 보상하기 어렵다. 음전하 축적은 전자빔을 대전된 영역에서 멀어지게 하고, 양전하 축적은 전자빔을 대전된 영역으로 향하게 한다.
5. 새로운 기술 동향
이차 전자 발생을 피하기 위해서는 저에너지 전자를 레지스트 노광을 위한 주요 방사선으로 사용하는 것이 필수적이다. 이상적으로는 이 전자들은 이차 전자를 생성하지 않고 레지스트를 노광하기 위해 몇 eV를 넘지 않는 에너지를 가져야 한다. 왜냐하면 충분한 과잉 에너지를 갖고 있지 않기 때문이다. 주사형 터널링 현미경을 전자빔 소스로 사용하여 이러한 노광이 시연되었다.[39] 데이터에 따르면 12 eV만큼 낮은 에너지를 가진 전자도 50 nm 두께의 폴리머 레지스트를 투과할 수 있다. 저에너지 전자를 사용하는 단점은 레지스트 내에서 전자빔의 확산을 방지하기 어렵다는 점이다.[40] 또한 고해상도를 위한 저에너지 전자 광학 시스템 설계도 어렵다.[41] 전자 간 쿨롱 반발력은 전자 에너지가 낮을수록 항상 더 심해진다.
전자빔 리소그래피의 또 다른 대안은 매우 높은 전자 에너지(최소 100 keV)를 사용하여 재료를 본질적으로 "드릴링"하거나 스퍼터링하는 것이다. 이 현상은 투과전자현미경에서 자주 관찰되었다.[42] 그러나 전자빔에서 재료로의 운동량 전달이 비효율적이기 때문에 이것은 매우 비효율적인 과정이다. 결과적으로 기존 전자빔 리소그래피보다 노광 시간이 훨씬 오래 걸리는 느린 과정이다. 또한 고에너지 빔은 항상 기판 손상에 대한 우려를 불러일으킨다.
전자빔을 사용한 간섭 리소그래피는 나노미터 크기의 주기를 갖는 패턴 배열을 위한 또 다른 가능성 있는 방법이다. 간섭계에서 광자 대신 전자를 사용하는 주요 장점은 동일한 에너지에 대해 훨씬 더 짧은 파장을 갖는다는 것이다.
다양한 에너지에서 전자빔 리소그래피의 여러 가지 복잡하고 미묘한 점에도 불구하고, 그것은 여전히 가장 작은 영역에 가장 많은 에너지를 집중시키는 가장 실용적인 방법으로 남아 있다.
처리량을 높이기 위해 리소그래피에 다중 전자빔 접근 방식을 개발하는 데 상당한 관심이 있었다. 이 작업은 SEMATECH와 Multibeam Corporation[43], Mapper[44], IMS[45]와 같은 신생 기업의 지원을 받았다. IMS Nanofabrication은 다중 빔 마스크 라이터를 상용화하여 2016년에 출시를 시작했다.[46]
5. 1. 저에너지 전자빔 리소그래피
저에너지 전자는 이차 전자 발생을 피하기 위해 레지스트 노광에 사용되는 주요 방사선이다. 이 전자들은 이상적으로 몇 eV를 넘지 않는 에너지를 가져야 하며, 이는 이차 전자 생성 없이 레지스트를 노광하기에 충분하다. 주사형 터널링 현미경을 전자빔 소스로 사용하여 이러한 노광이 시연되었다.[39] 12 eV만큼 낮은 에너지를 가진 전자도 50 nm 두께의 폴리머 레지스트를 투과할 수 있다는 것이 밝혀졌다.[40] 하지만 저에너지 전자를 사용하면 레지스트 내에서 전자빔의 확산을 방지하기 어렵고,[40] 고해상도를 위한 저에너지 전자 광학 시스템 설계도 어렵다.[41] 전자 간 쿨롱 반발력은 전자 에너지가 낮을수록 더 심해진다.right
전자빔 리소그래피의 또 다른 대안은 매우 높은 전자 에너지(최소 100 keV)를 사용하여 재료를 "드릴링"하거나 스퍼터링하는 것이다. 이 현상은 투과전자현미경에서 자주 관찰되었으나,[42] 전자빔에서 재료로의 운동량 전달이 비효율적이기 때문에 매우 느린 과정이다. 또한 고에너지 빔은 기판 손상에 대한 우려를 야기한다.
전자빔을 사용한 간섭 리소그래피는 나노미터 크기의 주기를 갖는 패턴 배열을 위한 또 다른 방법이다. 간섭계에서 광자 대신 전자를 사용하면 동일한 에너지에 대해 훨씬 더 짧은 파장을 얻을 수 있다는 장점이 있다.
전자빔 리소그래피는 가장 작은 영역에 가장 많은 에너지를 집중시키는 가장 실용적인 방법이다. 처리량을 높이기 위해 리소그래피에 다중 전자빔 접근 방식을 개발하는 데 상당한 관심이 있었으며, SEMATECH와 Multibeam Corporation[43], Mapper[44], IMS[45]와 같은 신생 기업의 지원을 받았다. IMS Nanofabrication은 다중 빔 마스크 라이터를 상용화하여 2016년에 출시를 시작했다.[46]
5. 2. 다중 전자빔 리소그래피
이차 전자 발생을 피하기 위해서는 저에너지 전자를 레지스트 노광을 위한 주요 방사선으로 사용하는 것이 필수적이다. 이상적으로는 이 전자들은 이차 전자를 생성하지 않고 레지스트를 노광하기 위해 몇 eV를 넘지 않는 에너지를 가져야 한다. 왜냐하면 충분한 과잉 에너지를 갖고 있지 않기 때문이다. 주사형 터널링 현미경을 전자빔 소스로 사용하여 이러한 노광이 시연되었다.[39] 데이터에 따르면 12 eV만큼 낮은 에너지를 가진 전자도 50 nm 두께의 폴리머 레지스트를 투과할 수 있다. 저에너지 전자를 사용하는 단점은 레지스트 내에서 전자빔의 확산을 방지하기 어렵다는 점이다.[40] 또한 고해상도를 위한 저에너지 전자 광학 시스템 설계도 어렵다.[41] 전자 간 쿨롱 반발력은 전자 에너지가 낮을수록 항상 더 심해진다.전자빔 리소그래피의 또 다른 대안은 매우 높은 전자 에너지(최소 100 keV)를 사용하여 재료를 본질적으로 "드릴링"하거나 스퍼터링하는 것이다. 이 현상은 투과전자현미경에서 자주 관찰되었다.[42] 그러나 전자빔에서 재료로의 운동량 전달이 비효율적이기 때문에 이것은 매우 비효율적인 과정이다. 결과적으로 기존 전자빔 리소그래피보다 노광 시간이 훨씬 오래 걸리는 느린 과정이다. 또한 고에너지 빔은 항상 기판 손상에 대한 우려를 불러일으킨다.
전자빔을 사용한 간섭 리소그래피는 나노미터 크기의 주기를 갖는 패턴 배열을 위한 또 다른 가능성 있는 방법이다. 간섭계에서 광자 대신 전자를 사용하는 주요 장점은 동일한 에너지에 대해 훨씬 더 짧은 파장을 갖는다는 것이다.
다양한 에너지에서 전자빔 리소그래피의 여러 가지 복잡하고 미묘한 점에도 불구하고, 그것은 여전히 가장 작은 영역에 가장 많은 에너지를 집중시키는 가장 실용적인 방법으로 남아 있다.
처리량을 높이기 위해 리소그래피에 다중 전자빔 접근 방식을 개발하는 데 상당한 관심이 있었다. 이 작업은 SEMATECH와 Multibeam Corporation[43], Mapper[44], IMS[45]와 같은 신생 기업의 지원을 받았다. IMS Nanofabrication은 다중 빔 마스크 라이터를 상용화하여 2016년에 출시를 시작했다.[46]
5. 3. 신소재 레지스트 개발
이차 전자 발생을 피하기 위해서는 저에너지 전자를 레지스트 노광을 위한 주요 방사선으로 사용하는 것이 필수적이다. 이상적으로는 이 전자들은 이차 전자를 생성하지 않고 레지스트를 노광하기 위해 몇 eV를 넘지 않는 에너지를 가져야 한다. 왜냐하면 충분한 과잉 에너지를 갖고 있지 않기 때문이다. 주사형 터널링 현미경을 전자빔 소스로 사용하여 이러한 노광이 시연되었다.[39] 데이터에 따르면 12 eV만큼 낮은 에너지를 가진 전자도 50 nm 두께의 폴리머 레지스트를 투과할 수 있다. 저에너지 전자를 사용하는 단점은 레지스트 내에서 전자빔의 확산을 방지하기 어렵다는 점이다.[40] 또한 고해상도를 위한 저에너지 전자 광학 시스템 설계도 어렵다.[41] 전자 간 쿨롱 반발력은 전자 에너지가 낮을수록 항상 더 심해진다.right
전자빔 리소그래피의 또 다른 대안은 매우 높은 전자 에너지(최소 100 keV)를 사용하여 재료를 본질적으로 "드릴링"하거나 스퍼터링하는 것이다. 이 현상은 투과전자현미경에서 자주 관찰되었다.[42] 그러나 전자빔에서 재료로의 운동량 전달이 비효율적이기 때문에 이것은 매우 비효율적인 과정이다. 결과적으로 기존 전자빔 리소그래피보다 노광 시간이 훨씬 오래 걸리는 느린 과정이다. 또한 고에너지 빔은 항상 기판 손상에 대한 우려를 불러일으킨다.
전자빔을 사용한 간섭 리소그래피는 나노미터 크기의 주기를 갖는 패턴 배열을 위한 또 다른 가능성 있는 방법이다. 간섭계에서 광자 대신 전자를 사용하는 주요 장점은 동일한 에너지에 대해 훨씬 더 짧은 파장을 갖는다는 것이다.
다양한 에너지에서 전자빔 리소그래피의 여러 가지 복잡하고 미묘한 점에도 불구하고, 그것은 여전히 가장 작은 영역에 가장 많은 에너지를 집중시키는 가장 실용적인 방법으로 남아 있다.
처리량을 높이기 위해 리소그래피에 다중 전자빔 접근 방식을 개발하는 데 상당한 관심이 있었다. 이 작업은 SEMATECH와 Multibeam Corporation[43], Mapper[44], IMS[45]와 같은 신생 기업의 지원을 받았다. IMS Nanofabrication은 다중 빔 마스크 라이터를 상용화하여 2016년에 출시를 시작했다.[46]
6. 주요 전자빔 노광 장치 제조사
- 뉴플레어테크놀로지(NFT) (구 도시바기계와 도시바의 합작회사에서 독립)
- 일본전자(JEOL)
- 히타치하이테크놀로지즈 (전자빔 노광장치 사업은 축소)
- 어드밴테스트
- 홀론
- 엘리오닉스
- 비스텍 세미컨덕터 시스템즈
- 리소텍재팬
- 크레스텍
- 매퍼 리소그래피
참조
[1]
서적
Microlithography
2007-01-04
[2]
논문
High-throughput NGL electron-beam direct-write lithography system
[3]
문서
Faster and lower cost for 65 nm and 45 nm photomask patterning
http://www.micronic.[...]
2016-06-00
[4]
논문
Inverse lithography for 45-nm-node contact holes at 1.35 numerical aperture
2009-00-00
[5]
학회
EBM-5000: electron-beam mask writer for 45-nm node
2006-00-00
[6]
학회
1-nm of local CD accuracy for 45-nm-node photomask with low sensitivity CAR for e-beam writer
2007-00-00
[7]
학회
Sidewall profile inclination modulation mask (SPIMM): modification of an attenuated phase-shift mask for single-exposure double and multiple patterning
2013-00-00
[8]
웹사이트
The Significance of Point Spread Functions with Stochastic Behavior in Electron-Beam Lithography
https://www.linkedin[...]
[9]
학회
Characteristics of fine feature hole templates for nanoimprint lithography toward 2nm and beyond
2022-00-00
[10]
서적
Fundamentals of Surface and Thin Film Analysis
North-Holland
[11]
웹사이트
EURONanochem – Chemical Control at the Nanoscale
http://www.arrs.gov.[...]
European Space Foundation
2008-01-00
[12]
논문
Plasma chemistry and surface processes of negative ions
[13]
논문
Quantitative electron spectroscopy of surfaces: A standard data base for electron inelastic mean free paths in solids
[14]
논문
Calculations of electron inelastic mean free paths. V. Data for 14 organic compounds over the 50–2000 eV range
https://mdr.nims.go.[...]
[15]
논문
Electron beam lithography—Resolution limits
[16]
논문
Secondary electron generation in electron-beam-irradiated solids:resolution limits to nanolithography
http://www.kps.or.kr[...]
[17]
웹사이트
SPIE Newsroom: Double exposure makes dense high-resolution diffractive optics
http://spie.org/x836[...]
Spie.org
2009-11-03
[18]
논문
Monte Carlo modeling in the low-energy domain of the secondary electron emission of polymethylmethacrylate for critical-dimension scanning electron microscopy
[19]
논문
Long-distance charge transport in duplex DNA: The phonon-assisted polaron-like hopping mechanism
[20]
논문
Secondary electron emission in the scanning electron microscope
[21]
웹사이트
Measurement of the role of secondary electrons in EUV resist exposures
https://www.euvlitho[...]
2013-00-00
[22]
웹사이트
Complexities of the Resolution Limits of Advanced Lithography
https://semiwiki.com[...]
[23]
웹사이트
Resolution Limits
https://www.linkedin[...]
[24]
비디오
Electron Blur Impact on Electron Beam and EUV Lithography
https://www.youtube.[...]
2023-00-00
[25]
학회
Multibeam mask requirements for advanced EUV patterning
2022-00-00
[26]
논문
Resist Requirements and Limitations for Nanoscale Electron-Beam Patterning
http://www.mrs.org/s[...]
2024-03-00
[27]
논문
The inclusion of secondary electrons and Bremsstrahlung X-rays in an electron beam resist model
[28]
논문
Novel Proximity Effect Including Pattern-Dependent Resist Development in Electron Beam Nanolithography
[29]
논문
Influence on the secondary electron yield of the space charge induced in an insulating target by an electron beam
[30]
논문
[31]
학회
MAPPER: high-throughput maskless lithography
2009-00-00
[32]
학회
Complementary polarity exposures for cost-effective line-cutting in multiple patterning lithography
2012-00-00
[33]
논문
Optimum dose for shot noise limited CD uniformity in electron-beam lithography
2004-00-00
[34]
논문
Low-energy electron-beam effects on poly(methyl methacrylate) resist films
[35]
학회
[36]
논문
Fabrication of 3 nm wires using 100 keV electron beam lithography and poly(methyl methacrylate) resist
[37]
논문
Resolution limits of electron-beam lithography toward the atomic scale
https://dspace.mit.e[...]
[38]
논문
E-Beam Nanostructuring and Direct Click Biofunctionalization of Thiol–Ene Resist
http://urn.kb.se/res[...]
[39]
논문
Electron-beam lithography with the scanning tunneling microscope
https://zenodo.org/r[...]
[40]
논문
Field emission characteristics of the scanning tunneling microscope for nanolithography
https://zenodo.org/r[...]
[41]
논문
Limits of low-energy electron optics
[42]
논문
Radiation damage in the TEM and SEM
[43]
웹사이트
Multibeam Corporation
http://www.multibeam[...]
2011-08-27
[44]
웹사이트
Mapper Lithography
http://www.mapperlit[...]
2011-08-27
[45]
웹사이트
IMS Nanofabrications
http://www.ims.co.at
2019-02-28
[46]
웹사이트
IMS Nanofabrications
https://www.ims.co.a[...]
2019-02-28
[47]
서적
Microlithography
2007-01-04
본 사이트는 AI가 위키백과와 뉴스 기사,정부 간행물,학술 논문등을 바탕으로 정보를 가공하여 제공하는 백과사전형 서비스입니다.
모든 문서는 AI에 의해 자동 생성되며, CC BY-SA 4.0 라이선스에 따라 이용할 수 있습니다.
하지만, 위키백과나 뉴스 기사 자체에 오류, 부정확한 정보, 또는 가짜 뉴스가 포함될 수 있으며, AI는 이러한 내용을 완벽하게 걸러내지 못할 수 있습니다.
따라서 제공되는 정보에 일부 오류나 편향이 있을 수 있으므로, 중요한 정보는 반드시 다른 출처를 통해 교차 검증하시기 바랍니다.
문의하기 : help@durumis.com